TSMC先进封装技术解析:3分钟读懂CoWoS/CoPoS/CoWoP谁将胜出
随着摩尔定律逐渐逼近物理极限,芯片制程微缩效益有限,业界正寻求新的破口,而先进封装(Advanced Packaging)成为近年最受瞩目的技术之一。 随着台积电的CoWoS产能逐渐供不应求,陆续出现CoPos、CoWoP等新技术,但这两个技术和CoWoS差在哪里? 何时开始导入?
以下内容来自台湾地区科技媒体《科技新报》整理解读:
下图可以看到,其实CoWoS、CoPos、CoWoP堆叠方式有些不同,例如CoPoS主要是将中间层改成面板RDL; CoWop 则是通过开发技术含量较高的 PCB 主板,来取代 IC 载板。
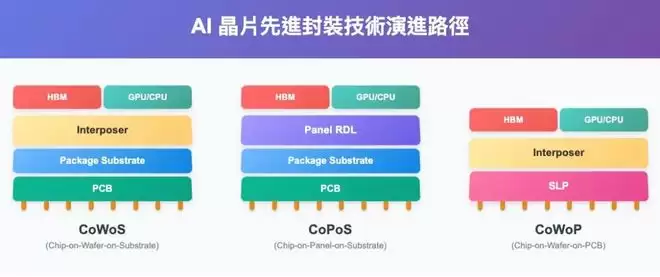
接着,我们来仔细介绍这三项技术的主要差异,但在此之前,要先了解这些延伸技术的根源──台积电的先进封装CoWoS。
台积电先进封装技术CoWoS,还细分为CoWoS-S、CoWoS-R、CoWoS-L
CoWoS 是台积电的 2.5D、3D 封装技术,可分成「CoW」和「WoS」来看。
CoW(Chip-on-Wafer)是芯片堆栈,WoS(Wafer-on-Substrate)则是将芯片堆叠在基板上,所以 CoWoS(Chip-on-Wafer-on-Substrate)的意思是把芯片堆叠起来,再封装于基板上,最终形成 2.5D、3D 的型态,可减少芯片的空间,同时减少功耗和成本。
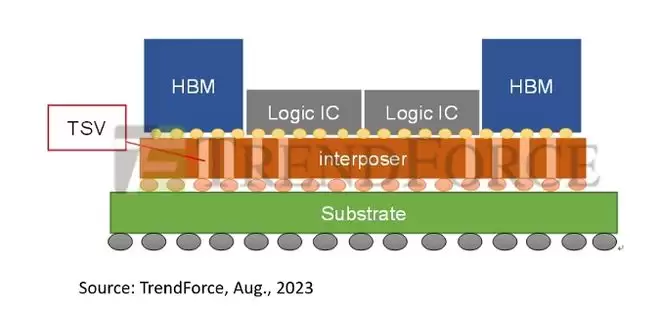
CoWoS 是先将逻辑芯片与 HBM(高带宽内存)安装在硅中间层(Interposer)上,透过中间层内部微小金属线来整合左右不同芯片的电子讯号,同时经由硅穿孔(TSV)来连接下方基板,将讯号导向下方,最终透过金属球(bumps)与外部电路衔接。
其中,CoWoS 技术又分成 CoWoS-R、CoWoS-L 和 CoWoS-S 三种技术,因中间层材质不同,成本也不同,客户可依据自身条件选择要哪样技术。
目前成本最高的是CoWoS-S,因为其中介层采用「硅」(Sillicon),也是主流方案,如NVIDIA H100、AMD MI300都使用CoWoS-S。 然而,CoWoS-S因使用高纯度硅材与TSV制程,加工难度大,且中间层面积受曝光机台限制,封装尺寸上限大约为2,500平方毫米。
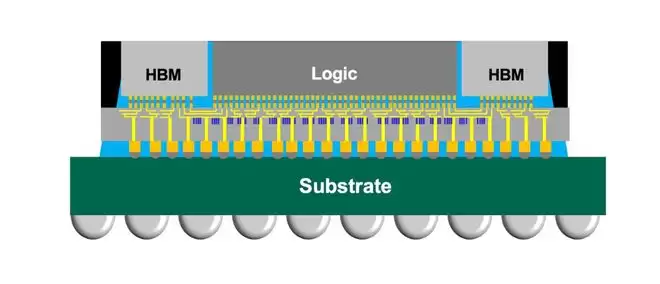
▲ CoWoS-S。 (Source:台积电,下同)
CoWoS-R 采用InFO中用到的互连技术,其中介层使用RDL(重布线层)来连接小芯片之间,支持弹性封装设计,适合对成本较为敏感的AIASIC应用、网通设备或边缘AI。
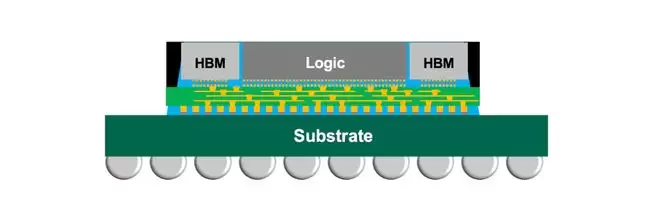
▲ CoWoS-R。
至于CoWoS-L成本介于CoWoS-S、CoWoS-R之间,中间层使用LSI(局部硅互连,Local Silicon Interconnect)和RDL,即局部区域以硅中间层串连芯片,其他区域用RDL或基板,实现密集的芯片与芯片连接,支持高达12颗HBM内存的堆叠应用,可说结合CoWoS-S和CoWoS-R/InFO的技术优点。
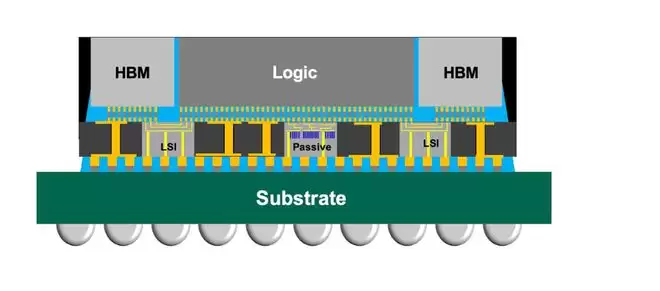
▲ CoWoS-L。
台积电高效能封装整合处处长侯上勇在Semicon Taiwan 2024 专题演讲中提到,由于顶部芯片(Top Die)成本非常高,CoWoS-L 是比 CoWoS-R、CoWoS-S 更能满足所有条件的最佳解,因此会从 CoWoS-S 逐步转移至 CoWoS-L,并称 CoWoS-L 是未来蓝图要角。
有趣的是,也有人认为CoWoS-L意思是Large,专为超大型AI训练平台与高集成度应用而设计,延续CoWoS-S架构,但进一步突破硅中间层尺寸限制,开发可支持超过2,500平方毫米的超大面积中间层技术。
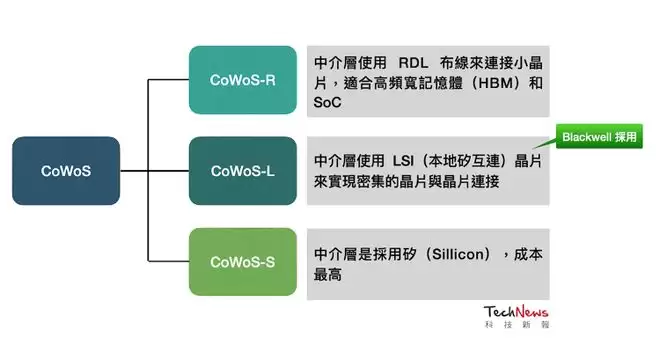
▲ CoWoS 技术路线图
CoWoS「面板化」! 解决成本、大尺寸芯片翘曲问题
了解CoWoS的技术分支后,接着来聊聊CoPoS和CoWoP。
由于AI芯片越来越大、设计越来越复杂,传统的圆形晶圆在面积利用率和封装效率逐渐受限,因此开始走向「以方代圆」,以面板(Panel)取代晶圆(Wafer),将芯片排列在矩形基板上,最后再透过封装制程连接到底层的加载板上,让多颗芯片可以封装一起,也就是所谓的「CoPoS」(Chip-on-Panel-on-Substrate)。

▲ CoPoS 示意图。 (Source:亚智科技)
CoPoS 是将芯片排列在方形「面板 RDL 层」,取代原先圆形的硅中间层,强化不同导电层与材料间的电路互连布局,提升面积利用率与产能。 此外,因导入玻璃或蓝宝石等新材料,方形尺寸可进行多颗芯片封装、整合不同尺寸芯片,同时支持更大光罩、缓解芯片越大越明显的翘曲问题。
业界分析,CoPoS是CoWoS-L或CoWoS-R的矩形变形概念,将传统300毫米硅晶圆改为方形面板设计,尺寸310×310毫米、515×510毫米或750×620毫米等,目前供应链研发方向皆以台积电释出的规格为主。 不过 CoPoS 初步尺寸选定采用 310×310 毫米。
业界传出,台积电预计2026年设立首条CoPoS实验线,目标2028年底至2029年之间实现量产,第一个客户就是NVIDIA。 此外,未来CoPoS封装的方向,主要锁定AI等高阶应用,采用CoWoS-R制程的将锁定博通,CoWoS-L则目标服务NVIDIA及AMD。
至于CoPoS 与 FOPLP(扇出型面板级封装,Fan-out Panel Level Packaging)差异在哪? 前者用于 AI 高端芯片、中间层材料是从硅转为玻璃,而后者用于 PMIC、RFIC 等低成本芯片的成熟制程,并不需要中间层,直接通过RDL 互连。
芯片测试技术研讨会报名(3月18日 西安)

游乐网为非赢利性网站,所展示的游戏/软件/文章内容均来自于互联网或第三方用户上传分享,版权归原作者所有,本站不承担相应法律责任。如您发现有涉嫌抄袭侵权的内容,请联系youleyoucom@outlook.com。
 同类文章
同类文章

4月汽车销量榜前十仅一款燃油车 燃油车时代即将落幕
四月新能源车零售渗透率突破61 4%,销量前十车型中仅剩一款燃油车。目前汽车保有量仍以燃油车为主,但市场趋势显示,车企正密集推出无需外接充电的油电混动车型,以满足充电不便用户的需求。同时,部分豪华品牌也放缓纯电路线,转向多元动力策略。油电混动成为连接燃油与电动化的重要。

ADC抗癌药市场迎来新入局者药企探索多元支付提升患者可及性
葛兰素史克ADC新药玛贝兰妥单抗在华获批,用于多发性骨髓瘤治疗。ADC药物市场快速增长,国内外药企加速布局,多款产品上市或通过授权合作出海。药企期待通过医保与商业保险等多元化支付体系提高药品可及性,减轻患者负担。

深圳福田AI生态亮相国际人工智能展
第七届深圳国际人工智能展览会开幕,福田区组织12家优质AI企业集体参展,涵盖芯片、硬件及行业解决方案。参展企业包括多家国家级高新技术与专精特新企业,聚焦算力硬件、垂直场景应用,展现区域产业活力与创新生态。展会为企业提供展示与合作平台,体现政策支持对AI发展的赋能作用。

央美陈抱阳解析AI与艺术融合情感认知智能技术如何革新美术教学
中央美术学院陈抱阳教授探讨了AI艺术的深层意义,强调研究应关注人如何观看AI及其对人类感知与情感的影响。他的创作融入中国文化传统,为具身智能艺术提供思想资源,不仅探索AI进入艺术的路径,更思考艺术如何重新定义AI的社会角色。艺术与AI的互动正改变技术理解、观看方式与教学逻辑。

方程豹豹5天神Max版上市 限时售价25.38万元
方程豹豹5天神Max版正式上市,限时售价25 38万元。新车核心尺寸与动力系统保持不变,系统总功率505kW。配置方面取消部分后排豪华功能,但保留了前排座椅加热通风按摩、中控与副驾娱乐屏及智能驾驶辅助系统,聚焦越野性能与核心科技,提供更具性价比的选择。
- 日榜
- 周榜
- 月榜
 1
1
 2
2
 3
3
 4
4
 5
5
 6
6
 7
7
 8
8
 9
9
 10
10
 相关攻略
相关攻略
 2015-03-10 11:25
2015-03-10 11:25
 2015-03-10 11:05
2015-03-10 11:05
 2021-08-04 13:30
2021-08-04 13:30
 2015-03-10 11:22
2015-03-10 11:22
 2015-03-10 12:39
2015-03-10 12:39
 2022-05-16 18:57
2022-05-16 18:57
 2025-05-23 13:43
2025-05-23 13:43
 2025-05-23 14:01
2025-05-23 14:01
 热门教程
热门教程
- 游戏攻略
- 安卓教程
- 苹果教程
- 电脑教程
































 热门话题
热门话题















