混合键合,大热
混合键合,被推到了台前。
免费影视、动漫、音乐、游戏、小说资源长期稳定更新! 👉 点此立即查看 👈
在Yole最新的预测中,混合键合是先进封装中最陡峭的增长曲线。三星、SK 海力士都表示,到HBM 5时就会用上混合键合技术。
目前,韩美半导体宣称砸1000亿韩元开发下一代混合键合技术;LG 电子瞄准HBM应用的混合键合设备;国内拓荆科技将混合键合设备视为第二增长曲线。
混合键合的时代到了。
01先进封装的转变
封装,已经成为驱动摩尔定律发展的重要因素,先进封装更是如此。
一般来说,封装模式的发展,伴随着键合方式的改变,键合发展的主线是实现更高密度的互联和更小的封装尺寸。
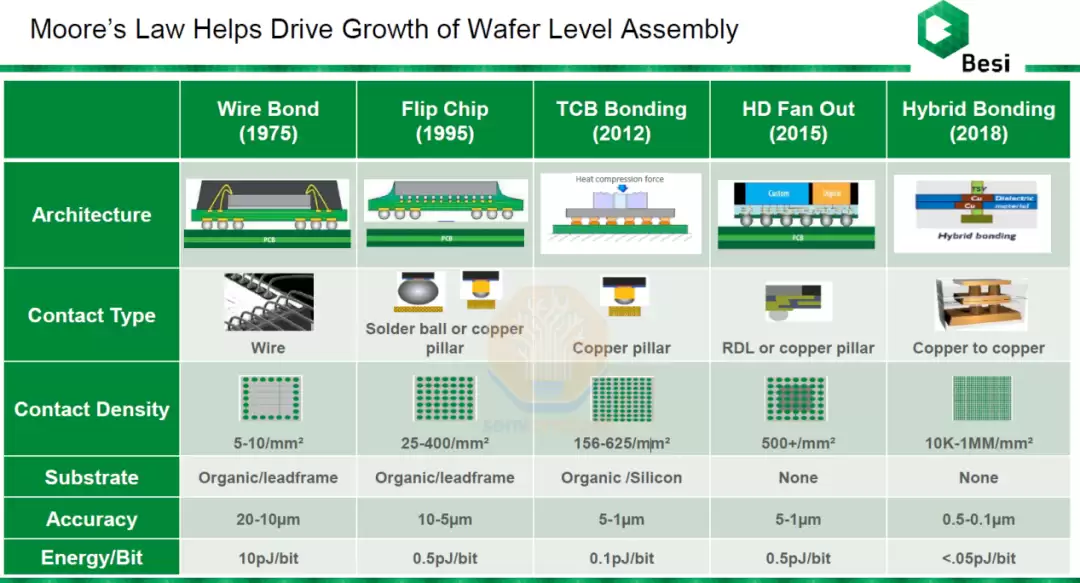
封装史上,经历过多次转变。
倒装芯片(Flip-Chip),作为封装史上的“常青树”,起源于20世纪60年代,是迄今应用最广、技术最成熟的方案之一。
把芯片功能区朝下以倒扣的方式背对基板,通过Bump和基板进行互联。不过,其核心短板也随芯片集成度提升愈发明显:倒装的回流焊是在炉里进行的,整个电路板都会被加热,冷却过程中因热膨胀系数不匹配可能造成键合减弱或芯片翘曲。
热压键合(TCB),由英特尔和ASMPT公司联合开发,在2014年导入量产。其核心创新在于 “局部加热”。
从顶部逐片对芯片施加热与压力实现键合,并且在芯片和基板热压键合的时候,不是加热整个基板,而是对芯片及其焊球加热,从而减小翘曲风险,兼顾了可靠性与封装效率,恰好契合了高带宽存储器(HBM)这类高密度堆叠产品的需求。
正因如此,目前三星、SK 海力士、美光等巨头的 HBM 产品,均将 TCB 作为标配封装方案,使其稳稳占据当前先进封装的“主流席位”。
混合键合,最大的特点就是无凸块连接。尽管TCB 技术解决了热胀问题,但封装行业对 更高密度互联的追求从未停止,而混合键合技术的出现,正是跳出了传统方案依赖凸块(Bump)的固有框架。
之前,在封装的时候,采用的都是基于焊料的凸块技术,现在混合键合能够采用铜对铜的连接,这就带来了三方面好处:第一,顶部芯片和底部芯片彼此齐平;第二,芯片间无凸块,能够微缩到超细间距;第三,不使用焊料,避免了与焊料相关的问题。
从技术迭代逻辑来看,混合键合与TCB并非简单的“替代”关系,而是针对不同需求场景的互补方案。
TCB 凭借成熟度和成本优势,仍是HBM等量产产品的首选;混合键合则瞄准未来更高集成度的芯片需求,比如3D堆叠层数突破20层的先进存储、算力密度极高的AI芯片等,成为行业布局下一代封装技术的核心方向。
从市场来看,TCB封装还是主流。Yole Group 估计,2025 年 TCB 键合机的收入约为 5.42 亿美元,预计到 2030 年将增长到约 9.36 亿美元,复合年增长率为 11.6%。订单量追踪着 HBM3E 的产能爬坡和向更厚堆栈的过渡,SK 海力士和美光在 2025 年上半年进行了大额采购。
据摩根大通预测,HBM用TCB键合机的整体市场规模将从 2024 年的 4.61 亿美元增长至 2027 年的 15 亿美元,增长两倍以上。
目前,TCB键合机市场目前呈“六强格局”。其中,韩国有韩美半导体、SEMES、韩华SemiTech,日本有东丽(Toray)、新川(Shinkawa),新加坡则有ASMPT。在这之中,韩美半导体在HBM TCB键合机市场上拥有最高的市场占有率。
TCB设备的火热,从韩美半导体的业绩中能够一窥究竟。韩美半导体近日发布的业绩预告显示,公司预计2025年第一季度合并营收达1400亿韩元(约6.9亿元人民币),营业利润达686亿韩元。与2024年同期相比,营收增长81%,营业利润增幅高达139%。并且,今年4月,韩美半导体已经正式通知韩国本土客户,用于制造HBM的TCB价格上涨25%。
02混合键合,应用多样
混合键合的提出,刷新了行业内封装的方式,也标志着半导体集成电路技术发生了根本性的转变。


目前混合键合有两种方式:一种是把单一尺寸的单个芯片键合到更大尺寸芯片的晶圆上(die-to-wafer:D2W),另一个是将两块相同尺寸的整块晶圆键合在一起(wafer-to-wafer:W2W)。

第一个吃螃蟹的是索尼。在2015年,索尼在CMOS图像传感器中应用了Cu-Cu直接键合,成为了第一个混合键合量产的产品。后来的一段时间里,混合键合一直用在CMOS图像传感器上。随着混合键合技术的成熟,逐渐走向了逻辑、3D NAND、HBM等场景。
2024年,AMD推出了首款垂直缓存(V-Cache) 游戏处理器Ryzen 7 5800X3D。这款处理器把计算和I/O 功能划分到独立的 Chiplet 中。其中最特别的一点就是,在计算 Chiplet 顶部增加了一个堆叠的 SRAM 扩展芯片,将 L3 缓存从 32 MB 扩展到 96 MB。这块额外的内存是在单独的芯片上制造的,但是用了混合键合进行连接,让扩展的缓存能够像直接集成在计算芯片上一样运行。
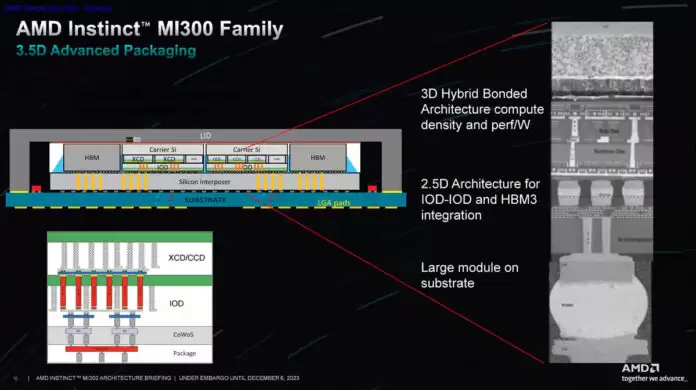
AMD Instinct MI300 系列架构芯片堆栈
2024年,AMD又推出了一款使用混合键合技术的芯片——专为 AI 训练应用而设计的Instinct MI300系列。凭借MI300,AMD 在利润丰厚的 AI 硬件市场上与 Nvidia 展开直接竞争。
在3D NAND领域,长江存储Xtacking架构,将CMOS和存储阵列进行混合键合,实现了更高的密度、更小的面积以及更快的速度。Xtacking 4.0能够实现IO速率3600MT/s。铠侠在最新的BiCS8 218 层 3D NAND 中采用了 CMOS 直接键合阵列 (CBA)。
03混合键合,大热
尽管应用的领域众多,但对于混合键合需求最突出的还是在HBM上。
不同于普通的内存更迭周期,HBM更新换代的速度越来越快。GPU供应商正在将新技术发布的频率加快到每年一次,这比内存标准的典型刷新周期要快得多。传统内存技术的转型通常需要四到五年时间,而HBM现在每两到两年半就会更新换代一次。
这对HBM提出了更高的要求。
韩国“海力士HBM 之父”Joungho Kim在今年强调:混合键合等新兴技术,将对未来内存设计起到决定性作用。
未来HBM 设计可能需要数十万甚至数百万个硅通孔。为支持如此高的密度,线路间距需大幅缩小。Joungho Kim认为,传统热压键合设备将难以跟上需求,混合键合技术因此变得不可或缺。目前键合间距仍处于数十微米级别,而下一代技术必须达到 1 微米级别。
分析机构TrendForce集邦咨询表示,三大 HBM 内存巨头在对堆叠高度限制、I/O 密度、散热等要求的考量下,已确定于HBM5 20hi(20层堆叠)世代全面应用混合键合技术。
三星这边,在首尔举行的人工智能半导体论坛上透露,该公司计划在其HBM4中采用混合键合技术,以降低发热量并实现超宽内存接口。此外,今年,三星也与长江存储签署了堆叠400 层NAND 所需的混合键合技术的专利许可协议。
SK 海力士在2024年就宣布,其用于HBM制造的混合键合工艺已获得可靠性认证。SK海力士第三代HBM(HBM2E)将DRAM堆叠成8层,在使用混合键合工艺制造后,通过了所有方面的可靠性测试。在今年4月,SK海力士副总裁表示,SK海力士正在推行混合键合在 HBM 上的应用。目前正处于研发阶段,预计最早将应用于HBM4E。
美光在2024年就从Xperi获得了Cu–Cu混合键合的授权,其HBM3E芯片封装采用了铜硅混合键合工艺。
火热的混合键合领域,也成为众多设备企业竞相追逐的焦点。
在混合键合赛道,全球混合键合设备市场主要由国际龙头企业主导,其中荷兰BESI是该领域的龙头,市占率高达67%。2024年至2024年,公司累计混合键合订单已经超过100套,2024年首批100nm精确度的混合键合设备出货,并计划在2025年底实现50nm精确度的混合键合设备。
韩美半导体也将混合键合视为未来更高HBM堆叠的关键。最近,韩美半导体率先掷下 “重磅炸弹”,宣布将豪掷 1000 亿韩元,全力进军混合键合技术的研发与生产领域。韩美半导体还制定了明确的设备发布规划,计划在2027年底前成功推出混合键合机设备。
无独有偶,ASMPT也在混合键合获得进展。从2024年开始布局混合键合,ASMPT在2024年第三季度向一家逻辑客户交付了首台混合键合设备,并获得了两台用于HBM应用的下一代混合键合设备的首次订单,预计将于2025年第三季度交付。
7月份,LG电子下属的生产技术研究所(PTI) 也传出已启动混合键合设备开发,目标在2028年实现大规模量产。
总而言之,混合键合技术的崛起,是半导体产业在摩尔定律逼近物理极限时的必然选择。从设备企业的重金投入,到各大厂商在不同领域的积极应用,都彰显出其蓬勃生命力。只有提前布局技术、构建产业链优势的玩家,才能在半导体产业的下一轮竞争中,握住决定格局的“关键筹码”。

游乐网为非赢利性网站,所展示的游戏/软件/文章内容均来自于互联网或第三方用户上传分享,版权归原作者所有,本站不承担相应法律责任。如您发现有涉嫌抄袭侵权的内容,请联系youleyoucom@outlook.com。
 同类文章
同类文章

AI能从单份血样检出多种神经疾病
来源:科技日报科技日报讯 (记者刘霞)由瑞典隆德大学领衔的国际研究团队,研发出一款新的人工智能(AI)模型。该模型仅需一份血液样本,便能精准识别多种神经退行性疾病。团队期望,该AI模型未来能实现“一

褪去虚火,脑机接口方能释放长远价值
来源:科技日报2026年开年,马斯克宣称脑机接口产品将于年内启动量产,引爆全球市场情绪。国内资本随即扎堆追捧,脑机接口相关概念股大幅走高,行业短期炒作虚火蔓延。进入3月,脑机接口迎来多重利好:脑机接

黎万强、洪锋退出小米科技股东名单
人民财讯4月7日电,企查查APP显示,近日,小米科技有限责任公司发生工商变更,原股东小米联合创始人黎万强、洪锋退出,同时,注册资本由18 5亿元减至约14 8亿元。 企查查信息显示,该公司成立于20

新闻分析|“阿耳忒弥斯2号”任务为何只绕月不登月
新华社北京4月7日电 新闻分析|“阿耳忒弥斯2号”任务为何只绕月不登月 新华社记者张晓茹 美国东部时间6日18时40分许(北京时间7日6时40分许),执行美国“阿耳忒弥斯2号”载人绕月飞行任

“链接未来·智汇静安”区块链创新应用优秀场景分享(四)| 信医基于区块链与隐私计算的真实世界研究数据产品
聚焦数字技术,释放创新动能。为集中展示静安区区块链技术从“实验室”走向“应用场”的丰硕成果,挖掘一批可复制、可推广的行业解决方案,加速构建区块链产业生态闭环,静安区数据局特推出“静安区区块链创新应用
- 日榜
- 周榜
- 月榜
 1
1
 2
2
 3
3
 4
4
 5
5
 6
6
 7
7
 8
8
 9
9
 10
10
 相关攻略
相关攻略
 2015-03-10 11:25
2015-03-10 11:25
 2015-03-10 11:05
2015-03-10 11:05
 2021-08-04 13:30
2021-08-04 13:30
 2015-03-10 11:22
2015-03-10 11:22
 2015-03-10 12:39
2015-03-10 12:39
 2022-05-16 18:57
2022-05-16 18:57
 2025-05-23 13:43
2025-05-23 13:43
 2025-05-23 14:01
2025-05-23 14:01
 热门教程
热门教程
- 游戏攻略
- 安卓教程
- 苹果教程
- 电脑教程

























 热门话题
热门话题















